封装直接影响着芯片的电性能、机械性能、热性能、可靠性,决定着整机电子系统的性能、小型化、可靠性和成本。

在这里封装实现了三大功能:1、保护:避免芯片受到外界环境化学的或物理的伤害;2、互联:引入电源给芯片供电,实现系统间信号互联;3、散热:将芯片的产生的热量散发到外界环境。
一、SiP封装工艺介绍
SiP封装工艺,是以一定的工序,在封装基板上,实现阻容感、芯片等器件的组装互连,并把芯片包封保护起来的加工过程。在这个过程中我们可以粗略的划分为以下工序(制程)。
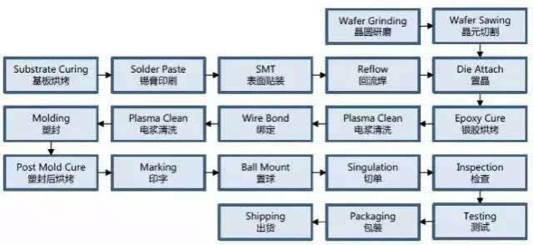
二、SiP封装工艺中的Wafer Grinding(晶圆研磨)工序
为保持一定的可操持性,Foundry出来的圆厚度一般在700um左右。封测厂必须将其研磨减薄,才适用于切割、组装,一般需要研磨到200um左右。其中晶圆研磨主要可分为下面三个步骤:Taping(贴膜) → Back Grinding(背面研磨) → Detaping(去膜)。 1、Taping(贴膜):在晶圆的正面(Active Area)贴上一层保护膜,保护芯片电路区域在研磨时不被刮伤,如下图所示。 2、Back Grinding(背面研磨):将贴膜后的晶圆放在真空吸盘上,真空吸盘其旋转。研磨砂轮转动的同时对晶圆施压,将其研磨到最终需要的厚度,如下图所示。 3、Detaping(去膜):晶圆研磨后,将保护膜经紫外光照射后剥离。

三、SiP封装工艺中的Dicing(晶圆切割)工序
晶圆切割流程主要有两个步骤:Wafer Mounting (晶圆贴片)→ Die Singulation(芯片切单)。 1、Wafer Mounting(晶圆贴片):贴膜的主要作用是防止芯片在切割时散落,另外也方便后续Die Attche工序拾取芯片。 2、Dicing芯片切割):芯片切割又叫划片,目前主要有两种方式:刀片切割和激光切割。当Wafer切割后,所有的芯片分离开后,将其放入晶圆框架盒中,流去下一工序。
昆山金博宝188官网网址 14年专注于等离子表面处理工艺研究,专业的等离子清洗机设备生产厂家,在等离子清洗机、大气低温等离子表面处理系统、大气常压等离子清洗机设备、真空等离子清洗机等等设备都有多年生产经验;如果你有等离子表面处理的需求,欢迎联系普乐斯,在线客服或者拨打全国服务热线400-816-9009,普乐斯随时为你服务哦!